|
|
随着半导体技术的飞速发展,IC在处理速度上的高速增长,处理能力上的增强,芯片内部结构日趋复杂。因而IC制造也遇到挑战,其封装形式的小型化与I/0端数量的增长的矛盾推动封装形式的革新。
1、双列直插式封装DIP(DualIn—line Package)
传统芯片因工艺、功能等诸多因素制约,多采用DIP形式封装,甚至有些采用SIP(Single In—line Package)封装。相对于采用SMD这样组装所占面积较大,给设备小型化带来困难,且组装自动化程度较低。64脚DIP封装的IC,安装面积为25.4mm*76.2mm,相同端数采用引脚中心距为0.64mm无引线器件进行表面安装,安装面积为12.7mm*12.7mm,仅为前者的l/12。
请输入描述

2、SMT常用封装
2.1、小外型封装SOP(Small Outline Package)
SOP器件又称为SOIC(Small Outline Integrated Circuit),是DIP的缩小形式,引线中心距为1.27mm,引脚形式:欧翼型、J型、I型,常用欧翼型。
请输入描述

2.2、塑封有引线芯片载体PLCC(Plastic Leaded Chip Carrier)
塑封有引线芯片载体PLCC,引线中心距为1.27mm,引线呈J形,向器件下方弯曲,有矩形、方形两种。PLCC器件组装面积小,引线强度高,不易变形,多根引线保证了良好的共面性,使焊点的一致性得以改善。因J形引线向下弯曲,检修有些不便。
请输入描述

2.3、方形扁平封装QFP(Quad Flat Package)
方形扁平封装QFP,主要应用于ASIC(Application Of SpecificIntegrated Circuit)专用集成电路。普通引线中心距为1.0mm、0.8mm、0.65mm、0.5mm,目前亦有采用0.3mmQFP。为保证引出线良好的共面性,美国的QFP器件四个脚都有一个突出的脚,其尺寸超过引出线O.05mm。
请输入描述

总结:综合上述介绍,I/O数量的增加是以牺牲引线间距为代价。间距的缩小给芯片制造、组装工艺提出更高要求,难度亦随之增加,加之间距亦有极限,因此即使I/O数较多的QFP的发展也受到间距极限的限制,因而更新型的封装,更先进的技术就呼之欲出。
3、球栅阵列BGA(Ball Grid Array)
正如前面总结所述,缩小间距不是解决I/O数增长最有效的解决方案。于是便有以封装底面来互连的解决办法,这便是面积阵列封装AAP(Area Array Package)。采用AAP,相同I/O数与组装面积,AAP间距明显较大,这使组装容易,芯片制造难度下降;相同的组装面积和间距,AAP可使I/O数增多;若间距、I/O数相同,AAP的组装面积明显较小,这使设备的小型化易于实现。因此AAP成为当前封装的热点和趋势。以结构形式划分,AAP可分为BGA和FC。BGA又可分为PBGA、CBGA、CCGA、TBGA四类,下面分述之。
3.1、塑封球栅阵列PBGA(Plastic Ball Grid Array)
PBGA是最普遍的BGA封装类型,其载体为普通的印制板基材,如FR—4等。硅片通过金属丝压焊方式连到载体的上表面,然后塑料模压成型。有些PBGA封装结构中带有空腔,称热增强型BGA,简称EBGA。
请输入描述
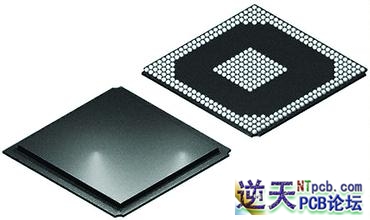
下表面为呈部分或完全分布的共晶组份(37Pb/63Sn)的焊球阵列,焊球间距通常为1.0mm、1.27mm、1.5mm。
PBGA有以下特点:
其载体与PCB材料相同,故组装过程二者的热膨胀系数TCE(Thermal Coefficient Of Expansion)几乎相同,即热匹配性良好。
组装成本低。
共面性较好。
易批量组装。
电性能良好。
3.2、陶瓷球栅阵列CBGA(CeramicBall Grid Array)
CBGA即是以多层陶瓷作载体,硅片采用金属丝压焊方式或采用硅片线路面朝下,以倒装片方式实现与载体的互联,然后用填充物包封,起到保护作用。陶瓷载体下表面是90Pb/10Sn的共晶焊球阵列,焊球间距常为1.0mm和1.27mm。CBGA具有如下特点:
优良的电性能和热特性。
密封性较好。
封装可靠性高。
共面性好。
封装密度高。
因以陶瓷作载体,对湿气不敏感。
封装成本较高。 组装过程热匹配性能差,组装工艺要求较高。
请输入描述

3.3、陶瓷柱栅阵列CCGA(CeramicCloumn Grid Array)
CCGA是CBGA的扩展,因此在制作工艺,性能上与CBGA相似。不同的是以90Pb/10Sn焊料柱替代了CBGA中的焊球,焊料柱的产生减小了组装过程PCB与陶瓷载体热性能失配产生的应力,但是焊料柱在组装过程中易受到机械损坏。CCGA的典型柱距为1.27mm。
请输入描述

3.4、载带球栅阵列TBGA(TapeBall Grid Array)
载带球栅阵列TBGA是载带自动键合TAB(Tape Automated Bonding)技术的延伸。TBGA的载体为铜/聚酰亚胺/铜的双金属层带(载带)。载体上表面分布的铜导线起传输作用,下表面的铜层作地线。硅片与载体实现互连后,将硅片包封起到保护作用。载体上的过孔实现上下表面的导通,利用类似金属丝压焊技术在过孔焊盘上形成焊球阵列。焊球间距有1.0mm、1.27mm、1.5mm几种。TBGA有以下特点:
封装轻、小。
电性能良。
组装过程中热匹配性好。
潮气对其性能有影响。
请输入描述

总结:综合上述介绍,BGA性能明显优于QFP,有良好的电性能,高I/O数。各类BGA的焊球、柱的组份基本是90Pb/10Sn(PBGA除外),间距基本上是1.0mm、l.27mm,因此间距还有进一步缩小的空间,这样I/O数将进一步增多。
芯片封装的发展是适应微组装技术FPT(Fine Pitch Technology)的发展而发展。朝轻、薄、小化,高I/O数,外形尺寸小,引线或焊球间距小的方向发展。随着技术的发展,性能将进一步提高,价格将会下降。这样电子组装的新时代将来临,整机性能将明显改善。
|
|